半导体产业网讯:近日,电子科技大学功率集成技术实验室罗小蓉团队在氧化镓器件的续流能力方提出一种具有低反向导通损耗的氧化镓纵向FinFET,并以Low Reverse Conduction Loss β-Ga2O3 Vertical FinFET with an Integrated Fin Diode为题在线发表于IEEE Transactions on Electron Devices期刊。

氧化镓(β-Ga2O3)由于其高禁带宽度(4.5-4.9eV)和高临界电场(8MV/cm),拥有比GaN和SiC器件更优的BFOM值,有助于在相同额定电压下降低传导损耗。目前对氧化镓场效应管的研究大多集中在如何获得高击穿电压(BV)和阈值电压(Vth)以及低比导通电阻 (Ron,sp)上。根据最近的研究,在β-Ga2O3场效应管中引入Fin通道,可以实现高BV和高Vth,但会导致反向导通电压(Von)变大并且损失反向导通。
低反向导通损耗有助于释放功率转换系统中感性负载引起的多余能量。使用反并联续流二极管用于反向导通,能降低Von,但会引入较大的寄生电感并导致额外的功率损耗和系统不稳定。使用单片集成肖特基势垒二极管(SBD)可以减少寄生参数,但温度依赖性差。到目前为止,对β-Ga2O3功率晶体管反向导通 特性的改善研究较少。
本文介绍了一种具有集成鳍型二极管(FD)的低反向导通损耗氧化镓纵向FinFET新结构(RC-FinFET),并利用Sentaurus TCAD仿真对其电学特性进行了研究分析。如图1(a)所示,RC-FinFET包括FinFET部分和FD部分,实现类MIS的导通和阻断特性。首先,在零偏置下,由于金属与β-Ga2O3的功函数差,MIS结构的耗尽作用使Fin沟道被夹断,实现常关的增强型器件;在正向导通和阻断状态下,FD的Fin沟道被夹断,几乎不影响阈值电压(Vth)和击穿电压(BV)。其次,由于Fin沟道的夹断作用,可以采用欧姆接触阳极替代肖特基接触,形成无结二极管。因此,在反向续流时,无结的FD实现极低的反向导通电压(Von);随反向偏置增加,沿Fin沟道侧壁形成电子积累层,提高反向电流能力。相较于无集成二极管的常规FinFET(C-FinFET),RC-FinFET的FinFET部分和FD部分可以分别调控Vth和Von,从而同时实现高Vth和低Von。如图1(b)所示,所提出的RC-FinFET具有极低的Von=0.45 V,相较于C-FinFET大大降低且不受栅压影响。RC-FinFET同时具有高Vth =1.6 V,高BV=2545 V,Baliga优值高达1.41 GW/cm2。此外,与外接续流二极管的传统方法相比,RC-FinFET减少了寄生电感和总芯片面积,增强了其在高功率和低损耗功率转换系统中的应用潜力。
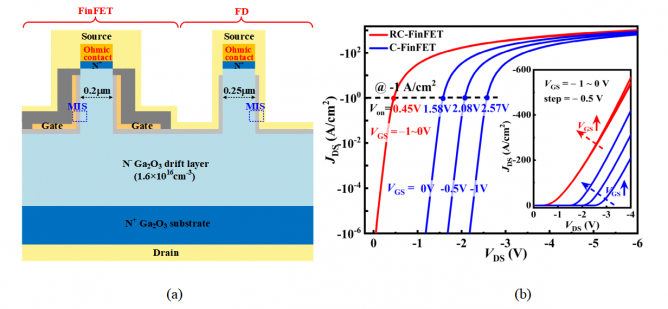
图1. (a) RC-FinFET结构示意图;(b) RC-FinFET与C-FinFET的反向导通性能对比。
文章的第一作者是电子科技大学博士生魏雨夕,通讯作者是电子科技大学罗小蓉教授和魏杰研究员。该项目由基础加强计划重点基础研究项目支持。
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。